ASTM F847-02
(Test Method)Standard Test Methods for Measuring Crystallographic Orientation of Flats on Single Crystal Silicon Wafers by X-Ray Techniques (Withdrawn 2003)
Standard Test Methods for Measuring Crystallographic Orientation of Flats on Single Crystal Silicon Wafers by X-Ray Techniques (Withdrawn 2003)
SCOPE
This standard was transferred to SEMI (www.semi.org) May 2003
1.1 These test methods cover the determination of , the angular deviation between the crystallographic orientation of the direction perpendicular to the plane of a fiducial flat on a circular silicon wafer, and the specified orientation of the flat in the plane of the wafer surface.
1.2 These test methods are applicable for wafers with flat length values in the range of those specified for silicon wafers in SEMI Specification M 1. They are suitable for use only on wafers with angular deviations of less than ± 5°.
1.3 The orientation accuracy achieved by these test methods depends directly on the accuracy with which the flat surface can be aligned with a reference fence and the accuracy of the orientation of the reference fence with respect to the X-ray beam.
1.4 Two test methods are covered as follows: SectionsTest Method A-X-Ray Edge Diffraction Method8 to 13Test Method B-Laue Back Reflection X-Ray Method14 to 18
1.4.1 Test Method A is nondestructive and is similar to Test Method A of Test Methods F 26 except that it uses special wafer holding fixtures to orient the wafer uniquely with respect to the X-ray goniometer. The technique is capable of measuring the crystallographic direction of flats to a greater precision than the Laue back reflection method.
1.4.2 Test Method B is also nondestructive, and is similar to Test Method E 82, and to DIN 50 433, Part 3, except that it uses" instant" film and special fixturing to orient the flat with respect to the X-ray beam. Although it is simpler and more rapid, it does not have the precision of Test Method A because it uses less precise and less expensive fixturing and equipment. It produces a permanent film record of the test.
Note 1—The Laue photograph may be interpreted to provide information regarding the crystallographic directions of wafer misorientation; however, this is beyond the scope of the present test method. Users desiring to carry out such interpretation should refer to Test Method E 82 and to DIN 50 433, Part 3, or to a standard X-ray textbook. With different wafer holding fixturing, Test Method B is also applicable to determination of the orientation of a wafer surface.
1.6 The values stated in inch-pound units are to be regarded as the standard. The values given in parentheses are for information only.
1.6 This standard does not purport to address all of the safety concerns, if any, associated with its use. It is the responsibility of the user of this standard to establish appropriate safety and health practices and determine the applicability of regulatory limitations prior to use. For specific hazard statements see Section 6.
General Information
Relations
Standards Content (Sample)
NOTICE: This standard has either been superceded and replaced by a new version or discontinued.
Contact ASTM International (www.astm.org) for the latest information.
Designation: F 847 – 02
Standard Test Methods for
Measuring Crystallographic Orientation of Flats on Single
1
Crystal Silicon Wafers by X-Ray Techniques
This standard is issued under the fixed designation F 847; the number immediately following the designation indicates the year of
original adoption or, in the case of revision, the year of last revision. A number in parentheses indicates the year of last reapproval. A
superscript epsilon (e) indicates an editorial change since the last revision or reapproval.
desiring to carry out such interpretation should refer to Test Method E 82
1. Scope
2 , 3
and to DIN 50 433, Part 3, or to a standard X-ray textbook. With
1.1 These test methods cover the determination of a, the
different wafer holding fixturing, Test Method B is also applicable to
angular deviation between the crystallographic orientation of
determination of the orientation of a wafer surface.
the direction perpendicular to the plane of a fiducial flat on a
1.5 The values stated in inch-pound units are to be regarded
circular silicon wafer, and the specified orientation of the flat in
as the standard. The values given in parentheses are for
the plane of the wafer surface.
information only.
1.2 These test methods are applicable for wafers with flat
1.6 This standard does not purport to address all of the
length values in the range of those specified for silicon wafers
safety concerns, if any, associated with its use. It is the
in SEMI Specification M 1. They are suitable for use only on
responsibility of the user of this standard to establish appro-
wafers with angular deviations of less than 65°.
priate safety and health practices and determine the applica-
1.3 The orientation accuracy achieved by these test methods
bility of regulatory limitations prior to use. For specific hazard
depends directly on the accuracy with which the flat surface
statements see Section 6.
can be aligned with a reference fence and the accuracy of the
orientation of the reference fence with respect to the X-ray
2. Referenced Documents
beam.
2.1 ASTM Standards:
1.4 Two test methods are covered as follows:
E 82 Test Method for Determining the Orientation of a
Sections
4
Metal Crystal
Test Method A—X-Ray Edge Diffraction Method 8 to 13
E 122 Practice for Choice of Sample Size to Estimate a
Test Method B—Laue Back Reflection X-Ray Method 14 to 18
5
Measure of Quality for a Lot or Process
1.4.1 Test Method A is nondestructive and is similar to Test
F 26 Test Methods for Determining the Orientation of a
Method A of Test Methods F 26 except that it uses special
6
Semiconductive Single Crystal
wafer holding fixtures to orient the wafer uniquely with respect
2.2 Other Standards:
to the X-ray goniometer. The technique is capable of measur-
Code of Federal Regulations, Title 10, Part 20, Standards
ing the crystallographic direction of flats to a greater precision
7
for Protection Against Radiation
than the Laue back reflection method.
SEMI Specification M 1, Polished Monocrystalline Silicon
1.4.2 Test Method B is also nondestructive, and is similar to
8
Wafers
Test Method E 82, and to DIN 50 433, Part 3, except that it
DIN 50 433, Part 3, Testing of Materials for Semiconductor
uses“ instant” film and special fixturing to orient the flat with
respect to the X-ray beam. Although it is simpler and more
rapid, it does not have the precision of Test Method A because
it uses less precise and less expensive fixturing and equipment.
2
Wood, E. A., Crystal Orientation Manual, Columbia University Press, New
It produces a permanent film record of the test.
York, NY, 1963.
3
Barret, C. S., and Massalski, T. B., The Structure of Metals, 3rd edition
NOTE 1—The Laue photograph may be interpreted to provide informa-
McGraw-Hill, New York, NY, 1966.
4
tion regarding the crystallographic directions of wafer misorientation;
Annual Book of ASTM Standards, Vol 03.01.
5
however, this is beyond the scope of the present test method. Users
Annual Book of ASTM Standards, Vol 14.02.
6
Annual Book of ASTM Standards, Vol 10.05.
7
Published in Federal Register, Nov. 16, 1960. Available from Superintendent of
Documents, U.S. Government Printing Office, Washington, DC 20402.
1
These test methods are under the jurisdiction of ASTM Committee F01 on
8
Available from the Semiconductor Equipment and Materials Institute, 3081
Electronics and are the direct responsibility of Subcommittee F01.06 on Silicon
Zanker Road, San Jose, CA 95134 (www.semi.org).
Materials and Process Control.
Current edition approved Dec. 10, 2002. Published February 2003. Originally
published in 1983. Last previous edition approved in 1994 as F 847 – 94 (1999).
Copyright © ASTM International, 100 Barr Harbor Drive, PO Box C700, West Conshohocken, PA 19428-2959, United States.
1
---------------------- Page: 1 ----------------------
NOTICE: This standa
...








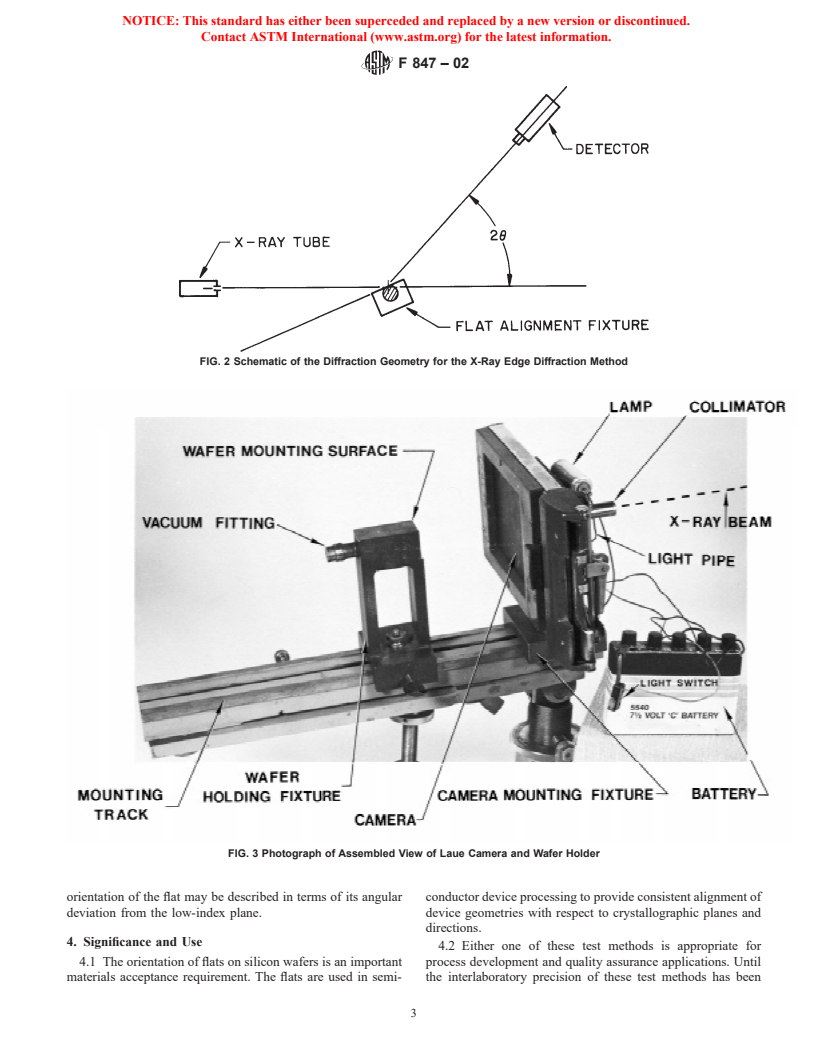
Questions, Comments and Discussion
Ask us and Technical Secretary will try to provide an answer. You can facilitate discussion about the standard in here.